т. 73, № 5, с. 392 (2003)
| ВЕСТНИК РОССИЙСКОЙ АКАДЕМИИ
НАУК
т. 73, № 5, с. 392 (2003) |
ЛИТОГРАФИЯ НА ДЛИНЕ ВОЛНЫ 13 нм
Член-корреспондент РАН С.В. Гапонов
Выступление на научной сессии общего собрания РАН
Обилие природных нанообъектов свидетельствует о выделенности наномира и перспективности работ по стимуляции самоорганизации и управляемого роста наноструктур. Примерами направленного формирования наноструктур могут служить полупроводниковые пленки нанометровой толщины и сверхрешетки, без которых немыслима современная электроника и многослойные зеркала для управления излучением экстремального ультрафиолетового и рентгеновского диапазонов.
На вопрос: можно ли делать так, чтобы все размеры, а не только толщина, не превышали нанометров? - уже дан положительный ответ. После того, как были построены приборы, позволяющие видеть отдельные атомы, - ионный проектор, электронный и зондовый микроскопы, немедленно начались работы по созданию наноструктур и даже наносхем. Но в электронной промышленности эти методы не могут конкурировать с традиционными. В мире добываются миллионы тонн кремния, значительная часть которого потребляется электронной промышленностью, и процессы получения рисунка с производительностью меньше 10 см2/с всерьез не рассматриваются.
Обычно рисунок будущих приборов и схем делается так. Сначала тем или иным путем изготавливается увеличенное изображение (маска) прибора, которое потом с уменьшением переносится на полупроводниковую пластинку, покрытую фоточувствительным слоем, то есть фотографируется с уменьшением. Дальнейший процесс изготовления прибора весьма сложен и включает много циклов травления и осаждения новых слоев различных материалов, но почти перед каждой операцией требуется нанесение фоточувствительного слоя (резиста) и фотографирование маски с каким-то новым рисунком. Процесс получения рисунка называют литографией, а установки, на которых это делают, - литографами.
Переход ко все более и более мелким размерам идет за счет совершенствования оптических схем и вспомогательных процессов. Когда возможности исчерпаны, переходят на все более короткие длины волн. Так были освоены диапазоны 248 нм и 193 нм, осваивается диапазон 157 нм. Как правило, события развиваются по следующему сценарию: сначала возникает нужный источник излучения, потом разрабатывается оптика, резис-ты, установки для экспонирования и начинается промышленное освоение диапазона. После освоения диапазона 157 нм подобный сценарий станет невозможным, так как более коротковолновое излучение сильно поглощается всеми веществами. Можно думать только об использовании зеркальной оптики, размещенной в вакууме.
Многослойные зеркала - одно из самых эффективных средств для управления экстремальным ультрафиолетовым и рентгеновским излучениями. Заметим, что диапазон, в которых они используются, очень широк (рис. 1). Если самые большие длины волн этого диапазона поделить на самые короткие, получится 3000 (для сравнения: в видимом диапазоне это отношение около 2). Естественно, в таком широком диапазоне происходит много природных явлений.

Рис. 1. Области применения многослойной экстремальной ультрафиолетовой (EUV)
и рентгеновской оптики, разрабатываемой в Институте физики микроструктур РАНИз этого диапазона нам предстояло выбрать длину волны для нанолитографии. Конечно, чем короче длина волны, тем лучше, однако для качественного воспроизведения рисунка маски объектив должен состоять из зеркал нормального падения, а это значит, что толщина двух слоев разных материалов должна быть равна половине длины волны излучения. Потому есть естественный предел длины волны для нанолитографии - это мономолекулярные слои. На практике предел наступает раньше и ограничивает рассматриваемую область со стороны коротких волн тем, что на рис. 1 обозначено как "окно прозрачности воды". Поскольку объективы предполагаются многозеркальными, а коэффициенты отражения (они всегда меньше единицы) перемножаются, для минимизации потерь нужен максимально большой коэффициент отражения каждого зеркала. Эти требования однозначно указывают на длину волны вблизи 13 нм *, на которой в настоящее время следует строить нанолитографию. Зеркала на этой длине волны сами являются наноструктурами - системой чередующихся пленок молибдена и кремния с периодом 6.5 нм.
* Более точно длина волны зависит от материала мишени. В настоящее время большинство предлагает ксенон, максимум излучения которого лежит на 13.5 нм.Чтобы построить литографический процесс на более чем в 10 раз меньшей длине волны, требуется пересмотреть всю технологию. Для его реализации необходимо разработать новые источники излучения на длине волны 13 нм, в 10 раз улучшить гладкость поверхности, точность формы и термостабильность оптических элементов, точность механических устройств установок экспонирования, фактически создать мир атомарных точностей. В таблице дан прогноз развития литографии в США, и в последней графе приведен объем памяти на чипе, что как-то характеризует рост мощности вычислительной техники. Мы видим, что, начиная с 2004 г., планируется использование экстремальной ультрафиолетовой (EUV) литографии в промышленном производстве. Что касается лабораторного варианта EUV литографии, то в 1998 г. на фирме "Моторола" получены первые чипы с минимальным размером элементов 70 нм, затем - 30 нм. В 1999 г. в Ливерморской национальной лаборатории США построен первый литограф, прообраз промышленного. Таким образом, в лабораторных экспериментах уже в 1998 г. достигнуты минимальные размеры элементов, планируемые в промышленности к 2013 г.
Источниками излучения могут быть синхротрон или плазма, разогретая лазерным импульсом либо электрическим разрядом. В первом литографе (a-Tool), изготовленном в США, для получения излучения на длине волны 13 нм используется лазерный разогрев мишени. Оптическая схема литографа с синхротронным источником показана на рис. 2.
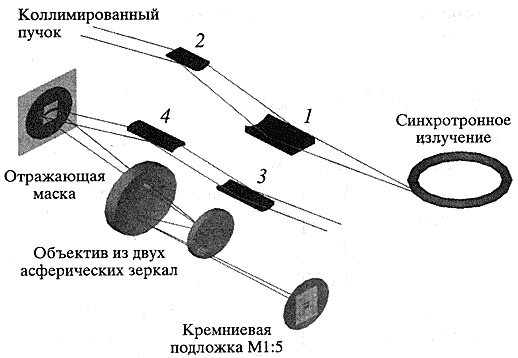
Рис. 2. Оптическая схема из двух асферических зеркал для литографа с синхротронным источником
1,2,3,4 - зеркала скользящего паденияПрограммы создания литографии на 13 нм существуют в США, Европейском союзе и Японии. Европейская программа несколько отстает от американской, хотя европейцы надеются почти одновременно с США придти к промышленному применению. В нашей стране развитие литографии на длине волны 248 ими 193 нм пришлось на смутное время. В литографии на длине волны 157 нм мы безнадежно отстали, и только наши работы в диапазоне 13 нм, благодаря хоздоговорному участию в европейской программе, выглядят прилично. Наши институты или группы ученых получают заказы на создание опытных образцов или технологий. Их использование и дальнейшее промышленное производство планируется за рубежом, но, насколько я знаю, все оговаривают право на применение результатов собственных исследований на территории России. Чтобы дать некоторое представление о положении дел, перечислю актуальные проблемы создания высокопроизводительной (Vexp > 10 см2/с) установки EUV-литографии с разрешением до 30 нм и отечественные организации, занимающиеся решением этих проблем в основном на деньги европейской программы:
• создание источника излучения - Институт спектроскопии РАН, Троицкий институт инновационных и термоядерных исследований. Институт лазерной физики, Физико-технический институт им. А.Ф. Иоффе РАН;Приведу несколько соображений в пользу государственного участия в решении всех этих проблем.• оптимизация оптической схемы - Ленинградский институт точной механики и оптики, РНЦ "Государственный оптический институт";
• создание основы зеркал, точность формы поверхности ~0.1 нм, микронеровностей ~0.2 нм - ГУП ЦКБ "Фотон", Институт лазерной физики;
• создание отражающих покрытий с R > 70% - Институт физики микроструктур РАН;
• создание методов компенсации напряжений в зеркалах - Институт физики микроструктур РАН;
• создание высокочувствительных резистов с пространственным разрешением до 30 нм - Институт химии Нижегородского государственного университета, Институт физики микроструктур РАН;
• создание отражающих масок с апертурой до 300 мм при плотности дефектов <10-2 см-2 - Институт физики микроструктур РАН;
• создание системы юстировки и совмещения рисунков на маске и резисте (точность позицирования <20 нм) - в СССР такие работы были сосредоточены в Минске.
Сейчас самое время собирать результаты, но, переданные за границу, они будут жить по своим законам, а наши представления о развитии нанолитографии без поддержки будут устаревать.
Вопрос о десятикратном повышении точности формы и ровности поверхности не решишь без создания новых средств измерения и новых технологий. Распространение их в другие области науки и техники приведет к качественным изменениям, а отсутствие этого сделает неконкурентоспособным большинство наших производств.
Начиная приблизительно с 15 нм, существенными будут эффекты размерного квантования, что заставит изменить логику построения электронных схем и, возможно, принципы создания вычислительной техники. Если не принять сейчас решительных действий, мы можем остаться не в той цивилизации. На мой взгляд, это имеет то же значение, как быть или не быть членом ядерного клуба.
В то же время, если не разбрасываться и, по примеру США, объединить действительно работающих в данном направлении в некую виртуальную лабораторию (по моим оценкам, это около 100 человек) и финансировать в течение пяти лет их работу из расчета 50 тыс. долл. на человека в год (меньшее не позволит приобретать и заказывать необходимое для успешной работы оборудование), сейчас еще не поздно решить проблему развития наноэлектроники и атомноточных технологий.
Июнь 2003